Microscopy & Microtechniques
New AFM Semiconductor Characterisation Solution Introduced
Jun 04 2013
Bruker has announced the release of the Dimension Icon® SSRM-HR, a new atomic force microscope (AFM) configuration including the Scanning Spreading Resistance Microscopy (SSRM) module, designed specifically for high-resolution (HR) semiconductor characterisation. Integrating Bruker’s industry-leading Dimension Icon AFM platform with an environmental control system capable of 1ppm gas purity and high-vacuum control, the Dimension Icon SSRM-HR system provides vastly improved repeatability and spatial resolution in semiconductor carrier profiling.
“As our customers continue to improve their products to follow the semiconductor roadmap, higher spatial resolution electrical characterisation is a key requirement,” said David V. Rossi, Executive Vice President and General Manager of Bruker's AFM Business. “The new Dimension Icon SSRM-HR combines the leading productivity and large programmable stage of our top performance AFM platform with atomic resolution, and the most accurate carrier profiling optimisation to meet the specific demands of next-generation technology nodes.”
Digital Edition
ILM 49.5 July
July 2024
Chromatography Articles - Understanding PFAS: Analysis and Implications Mass Spectrometry & Spectroscopy Articles - MS detection of Alzheimer’s blood-based biomarkers LIMS - Essent...
View all digital editions
Events
Jul 30 2024 Jakarta, Indonesia
Jul 31 2024 Chengdu, China
ACS National Meeting - Fall 2024
Aug 18 2024 Denver, CO, USA
Aug 25 2024 Copenhagen, Denmark
Aug 28 2024 Phnom Penh, Cambodia


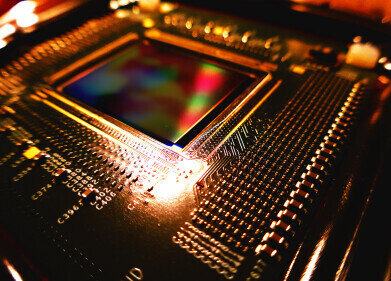








24_06.jpg)






